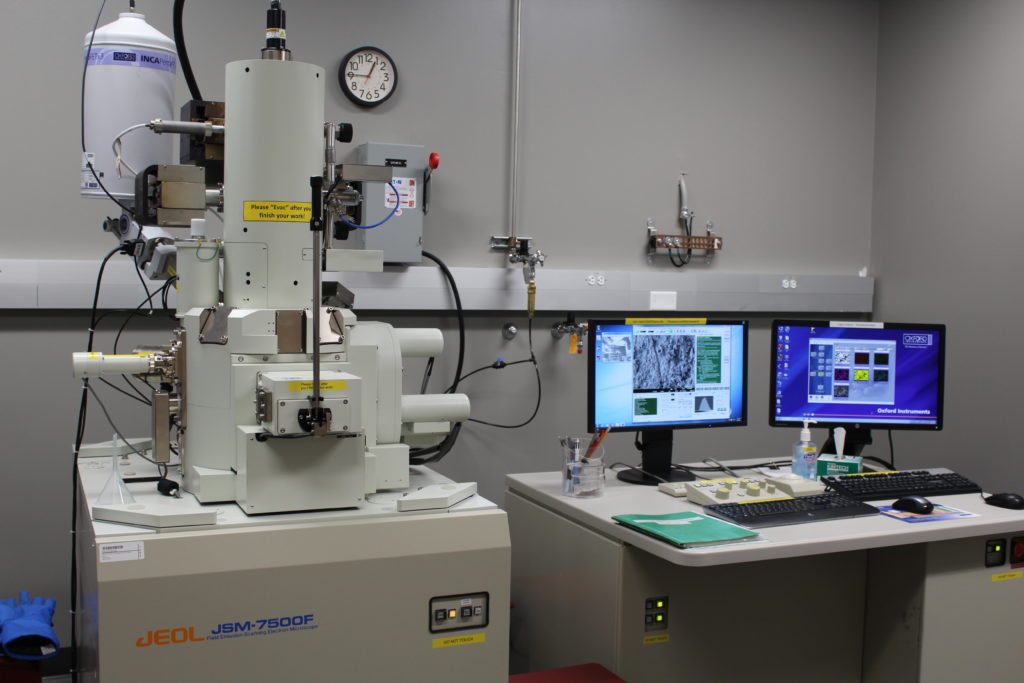
The JEOL JSM-7500F is an ultra high resolution field emission scanning electron microscope (FE-SEM) equipped with a high brightness conical FE gun and a low aberration conical objective lens).
The improved overall stability of the JSM-7500F enables you to readily observe your specimen at magnifications up to 1,000,000x with the guaranteed resolution of 1 nm.
The energy filter (r-filter) makes it possible to observe the fine surface morphology of nanostructures.
The unique Gentle Beam (GB) mode decelerates incident electrons just before they hit the specimen to reduce the incident-electron penetration and the charging in the specimen. The GB mode provides high-resolution images whose quality is as high as those of higher accelerating voltages, even at low accelerating voltages from 100 V to 3 kV without damaging the specimen surface.
Source: Cold cathode UHV field emission conical anode gun
Resolution: 1.0 nm guaranteed at 15kV; 2.2 nm guaranteed at 1.0kV
Acc. voltage: 0.5 to 30kV (SEM or LM mode); 10 V steps from 0.5 to 2.9 kV; 100 V steps from 2.9 to 30 kV
Mag. range: 25x to 19,000x in LM mode; 100x to 650,000x in SEM mode
Probe current: 1 x 10-13 order to > 2 x 10-9 Amps (continuous)
Accessories associated with the JSM-7500 include: conventional in-chamber Everhart-Thornley and through-the-lens secondary detectors, low angle back-scattered electron detector (LABE), IR-CCD chamber camera, Oxford EDS system equipped with X-ray mapping and digital imaging.
To be trained on this instrument, please contact Dr. Yordanos Bisrat.